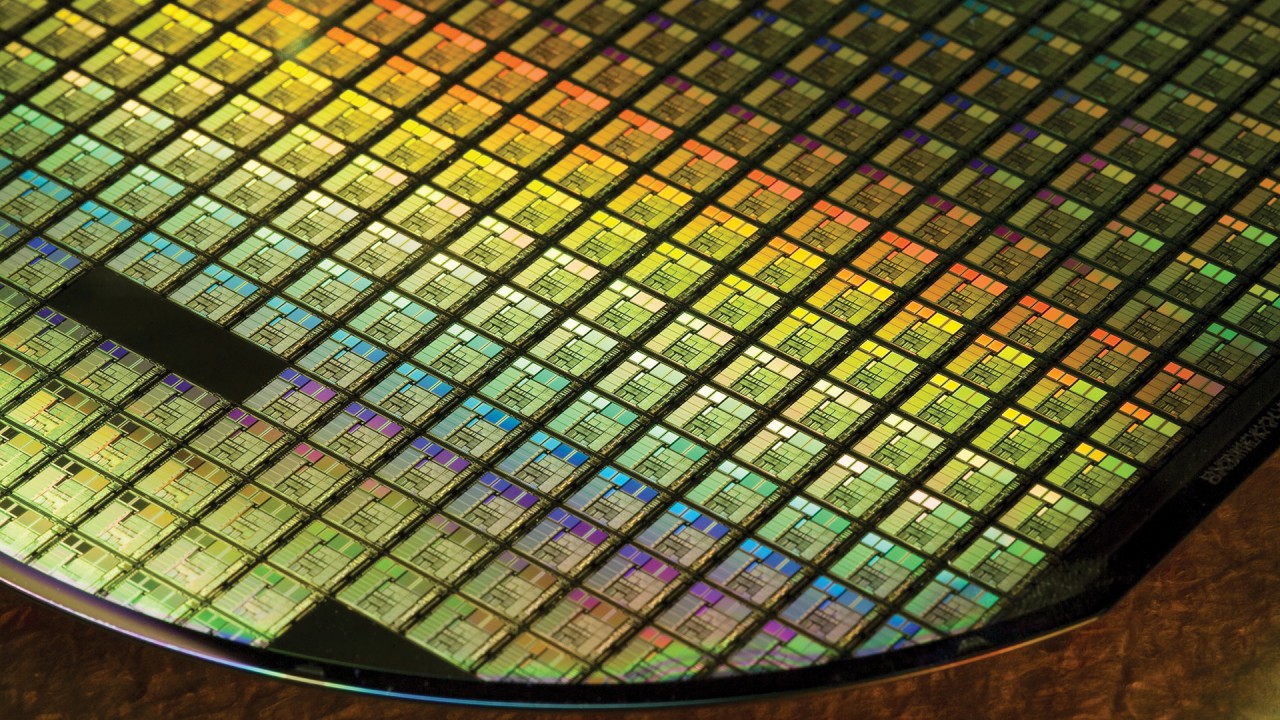
Корпорация Intel представила новую технологию межблочных соединений для трехмерных чипов, которая позволит инженерам создавать микросхемы из компактных специализированных модулей, по аналогии с конструктором Lego.
Большинство современных процессоров имеют монолитный дизайн, в котором все транзисторы и вспомогательные компоненты размещены на одной кремниевой матрице. В течение десятилетий этот подход хорошо работал, но из-за сложности дальнейшего увеличение скорости обработки, производители разрабатывают новые пути развития отрасли, чтобы оправдывать ожидания потребителей.
Intel планирует решить этот вопрос с помощью технологии Omni-Directional Interconnect (ODI), которая устраняет необходимость использования только одного кристалла, позволяя собирать процессоры из различных модулей, называемых чиплетами.
Одним из преимуществ этого подхода является гибкость. ODI позволит компании смешивать и сочетать чипы разных конструкций, которые обычно продаются отдельно, в мощных, специально настроенных процессорах, оптимизированных для конкретных приложений.
Новая технология поможет снизить производственные затраты. Если один из чиплетов в модульном процессоре имеет дефект, его можно просто заменить, что избавляет от необходимости списывать весь блок.
ODI облегчает модульность, объединяя две существующие технологии компании. Первая, EMIB, позволяет связывать чиплеты по горизонтали, как элементы пазла, а другая, Foveros, дает возможность размещать их один поверх другого в трехмерной структуре.
Новое решение также вносит существенное улучшение в дизайн. Intel значительно увеличила размер сквозных кремниевых переходов и электрических соединений, которые передают энергию и данные между чиплетами. Такие изменения обеспечат увеличение пропускной способности и сократят задержку, используя при этом меньше переходных отверстий, что высвобождает пространство для дополнительных транзисторов.
Модульные трехмерные чипы Intel могут появиться на рынке в ближайшем будущем. В декабре компания заявила, что надеется начать поставки модульных процессоров на базе Foveros в 2019 году, а также сообщила о разработке революционного типа транзисторов, потребляющих в 30 раз меньше энергии.
текст: Илья Бауэр, фото: mtdata
